Caracterización de materiales
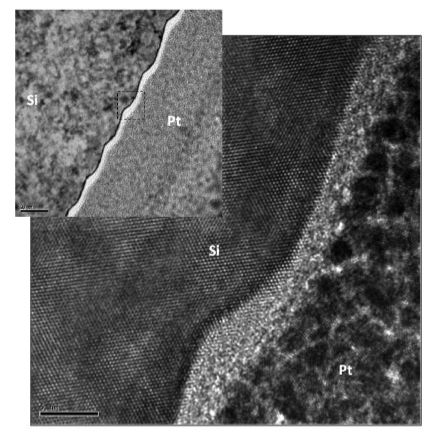
Philips Tecnai 20 FEG:
-Campo claro/campo oscuro permite la identificación de defectos presentes en el material, dislocaciones, fronteras de grano, etc, asi como ver su distribución a partir de imágenes de campo claro y/o campo oscuro en condiciones de dos haces a baja resolución o directamente a partir de imágenes de alta resolución.
-Diagramas de difracción de electrones (EDP) con este método se obtiene la estructura cristalina a nivel atómico del material analizado, directamente a partir de imágenes de alta resolucion y simulación mediante transformada de Fourier o diagramas de difracción de electrones.
-STEM-HAADF permite conocer la composición química de partículas con un tamaño inferior a los 0.5 nm mediante espectros de fluorescencia de rayos X in situ. Se realizan mapas de composición en modo STEM-HAADF con la misma resolución.
-Campo claro/campo oscuro en modo HAADF permite la identificación de precipitados o nuevas fases presentes en los materiales, la caracterización estructural y química, el estudio de intercaras, las relaciones de orientación precipitado/matriz, etc.
El objetivo final es analizar la estructura cristalina a escala atómica y su posible relación con las propiedades de los materiales.
Preparación de muestras:
-En plan view.
-Sección transversal.
-Precipitados en rejillas de carbono.
Sección transversal a lo largo de la dirección <110> de una muestra de Si (100) pulverizado con irradiación de haz de iones de baja energía de Xe+.
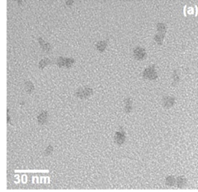


(a) Imagen de TEM de nanopartículas de FeB. (b) Histograma de distribución de diámetro extraído de varias imágenes TEM. (c) Análisis EDX de la estructura química de la nanapartícula.